Aplicación na industria dos semicondutores
GREEN é unha empresa nacional de alta tecnoloxía dedicada á I+D e á fabricación de equipos de montaxe electrónica automatizada e envasado e proba de semicondutores. Da servizo a líderes da industria como BYD, Foxconn, TDK, SMIC, Canadian Solar, Midea e máis de 20 empresas da lista Fortune Global 500. O seu socio de confianza para solucións de fabricación avanzadas.
As máquinas de unión permiten microinterconexións con diámetros de fíos, garantindo a integridade do sinal; a soldadura ao baleiro con ácido fórmico forma unións fiables con contido de osíxeno <10 ppm, evitando fallos de oxidación en empaquetados de alta densidade; AOI intercepta defectos a nivel de micras. Esta sinerxía garante un rendemento de empaquetado avanzado >99,95 %, cumprindo as esixencias de proba extremas dos chips 5G/IA.

Selladora de fíos ultrasónica
Capaz de unir arames de aluminio de 100 μm a 500 μm, arames de cobre de 200 μm a 500 μm, cintas de aluminio de ata 2000 μm de ancho e 300 μm de grosor, así como cintas de cobre.
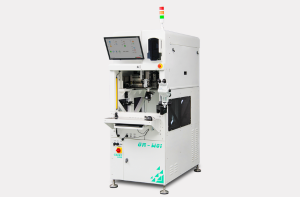
Rango de desprazamento: 300 mm × 300 mm, 300 mm × 800 mm (personalizable), con repetibilidade < ±3 μm

Rango de percorrido: 100 mm × 100 mm, con repetibilidade < ±3 μm
Que é a tecnoloxía de unión por fíos?
A unión por fíos é unha técnica de interconexión microelectrónica empregada para conectar dispositivos semicondutores aos seus envases ou substratos. Como unha das tecnoloxías máis importantes da industria dos semicondutores, permite a interface de chips con circuítos externos en dispositivos electrónicos.
Materiais de arame de unión
1. Aluminio (Al)
Condutividade eléctrica superior fronte ao ouro, rendible
2. Cobre (Cu)
Condutividade eléctrica/térmica un 25 % maior que a do au
3. Ouro (Au)
Conductividade óptima, resistencia á corrosión e fiabilidade da unión
4. Prata (Ag)
Maior condutividade entre os metais
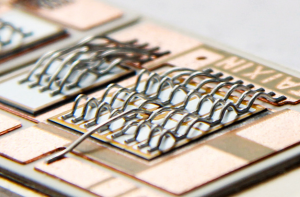
fío de aluminio

Cinta de aluminio

fío de cobre

Cinta de cobre
Unión de chips de semicondutores e unión de fíos AOI
Emprega unha cámara industrial de 25 megapíxeles para detectar defectos de conexión de chips e unións de cables en produtos como circuítos integrados, IGBT, MOSFET e marcos de conexións, conseguindo unha taxa de detección de defectos superior ao 99,9 %.

Casos de inspección
Capaz de inspeccionar a altura e planitude da lasca, o desprazamento da lasca, a inclinación e o desconchado; a falta de adhesión da bóla de soldadura e o desprendemento da unión de soldadura; os defectos de unión dos fíos, incluíndo a altura excesiva ou insuficiente do bucle, o colapso do bucle, os fíos rotos, os fíos que faltan, o contacto cos fíos, a dobradura dos fíos, o cruzamento do bucle e a lonxitude excesiva da cola; a insuficiencia de adhesivo; e as salpicaduras de metal.
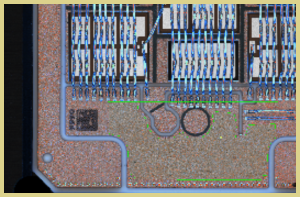
Bóla/Residuo de Soldadura

Raspadura de chip

Colocación de chips, dimensión, medición de inclinación
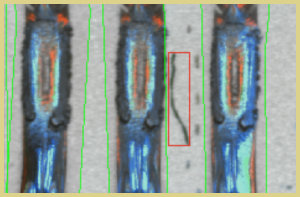
Contaminación do chip/Material estraño
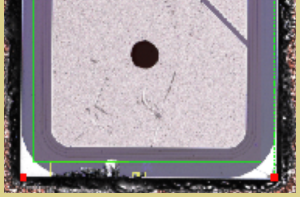
Trituración de chips
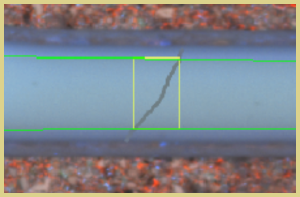
Gretas de gabia cerámica

Contaminación de gabias cerámicas
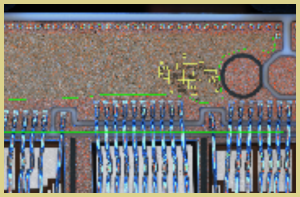
Oxidación AMB
Forno de refluxo de ácido fórmico en liña

1. Temperatura máxima ≥ 450 °C, nivel de baleiro mínimo < 5 Pa
2. Admite ambientes de proceso con ácido fórmico e nitróxeno
3. Taxa de baleiro nun só punto ≦ 1%, taxa de baleiro global ≦ 2%
4. Refrixeración por auga + refrixeración por nitróxeno, equipada cun sistema de refrixeración por auga e refrixeración por contacto
Semicondutores de potencia IGBT
As taxas de baleiros excesivas na soldadura IGBT poden desencadear fallos por reacción en cadea, incluíndo fuga térmica, rachaduras mecánicas e degradación do rendemento eléctrico. Reducir as taxas de baleiros a ≤1 % mellora substancialmente a fiabilidade e a eficiencia enerxética do dispositivo.
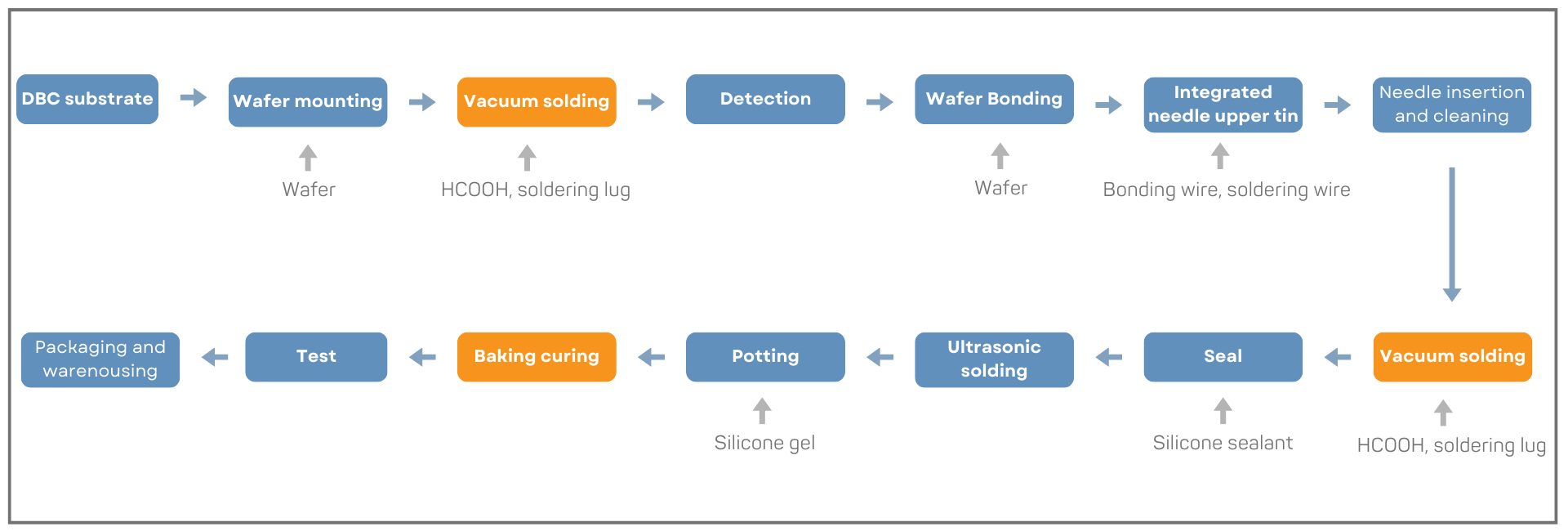
Diagrama de fluxo do proceso de produción de IGBT








